OSP 是 Organic Solderability Preservatives 的簡稱,中譯為有機保焊膜,又稱護銅劑,英文亦稱之
Preflux.本章就以護銅劑稱之.
14.2.1
種類及流程介紹
A. BTA(苯駢三氯唑):BENZOTRIAZOLE
BTA 是白色帶淡黃無嗅之晶狀細粉,在酸堿中都很安定,且不易發生氧化還原反應,能 與金 屬形成安定化合物。ENTHON 將之溶於甲醇與水溶液中出售,作銅面抗氧化劑(TARNISH AND OXIDE RESIST),商品名為 CU-55 及 CU-56,經 CU-56 處理之銅面可產生保護膜,防止裸銅迅速 氧化。
操作流程如表。
B. AI(烷基咪唑) ALKYLIMIDAZOLE PREFLUX 是早期以 ALKYLIMIDAZOLE 作為護銅劑而開 始,由日本四國化學公司首先 開發之商品,於 1985 年申請專利,用於蝕刻阻劑(ETCHING RESIST),但由於色呈透明檢 測不易,未大量使用。其後推出 GLICOAT 等,系由其衍生而來。
GLICOAT-SMD(E3)具以下特性:
-與助焊劑相容,維持良好焊錫性
-可耐高熱焊錫流程
-防止銅面氧化 操作流程如表。
C. ABI (烷基苯咪唑) ALKYLBENZIMIDZOLE
由日本三和公司開發,品名為 CUCOAT A ,為一種耐濕型護銅劑。 能與銅原子產生錯合物
(COMPLEX COMPOUND),防止銅面氧化,與各類錫膏皆相容,對焊錫性有正面效果。 操作流程如表。
D. 目前市售相關產品有以下幾種代表廠家:
醋酸調整系統:
GLICOAT-SMD (E3) OR (F1) WPF-106A (TAMURA) ENTEK 106A (ENTHON) MEC CL-5708 (MEC)
MEC CL-5800(MEC)
甲酸調整系統:
SCHERCOAT CUCOAT A KESTER
大半藥液為使成長速率快而升溫操作,水因之蒸發快速,PH 控制不易,當 PH 提高時會導致
MIDAZOLE 不溶而產生結晶,須將 PH 調回。一般採用醋酸(ACETIC ACID)或甲酸 (FORMIC ACID)調整。
14.2.2
有機保焊膜一般約 0.4μm 的厚度就可以達到多次熔焊的目的,雖然廉價及操作單純,但有以 下缺點:
A. OSP 透明不易測量,目視亦難以檢查
B. 膜厚太高不利於低固含量,低活性免洗錫膏作業,有利於焊接之 Cu6Sn5 IMC 也不易形成
C. 多次組裝都必須在含氮環境下操作
D. 若有局部鍍金再作 OSP,則可能在其操作槽液中所含的銅會沉積于金上,對某些產品會形成 問題
E. OSP Rework 必須特別小心
14.3 化學鎳金
14.3.1 基本步驟 脫脂→水洗→中和→水洗→微蝕→水洗→預浸→鈀活化→吹氣攪拌水洗→無電鎳→熱水洗→無電金→回收水洗→後處理水洗→乾燥.
14.3.2 無電鎳
A. 一般無電鎳分為"置換式"與"自我催化"式其配方極多,但不論何者仍以高溫鍍層品質較佳 B.一般常用的鎳鹽為氯化鎳(Nickel Chloride) C.一般常用的還原劑有次磷酸鹽類(Hypophosphite)/甲醛(Formaldehyde)/聯氨 (Hydrazine)/硼氬化
合物(Borohydride)/硼氫化合物(Amine Borane)
D.螯合劑以檸檬酸鹽(Citrate)最常見 E.槽液酸鹼度需調整控制,傳統使用氨水(Amonia),也有配 方使用三乙醇氨(Triethanol Amine),除可調整 PH 及比氨水在高溫下穩定,同時具有與檸檬酸鈉結 合共為鎳金屬螯合劑,使鎳可順利有效地沉積於鍍件上
F.選用次磷二氫鈉除了可降低污染問題,其所含的磷對鍍層品質也有極大影率
G.此為化學鎳槽的其中一種配方 配方特性分析:
a.PH 值的影響:PH 低於 8 會有混濁現像發生,PH 高於 10 會有分解發生,對磷含量及沉 積 速率及磷含量並無明顯影響
b.溫度的影響:溫度影響析出速率很大,低於 70°C 反應緩慢,高於 95°C 速率快而無 法控 制.90°C 最佳
c.組成濃度中檸檬酸鈉含量高,螯合劑濃度提高,沉積速率隨之下降,磷含量則隨螯合 劑濃 度增加而升高,三乙醇氨系統磷含量甚至可高到 15.5%上下
d.還原劑次磷酸二氫鈉濃度增加沉積速率隨之增加,但超過 0.37M 後槽液有分解現像, 因此 其濃度不可過高,過高反而有害。磷含量則和還原劑間沒有明確關係,因此一般 濃度控制在 O.1M 左右較洽當
e.三乙醇氨濃度會影響鍍層的磷含量及沉積速率,其濃度增高磷含量降低沉積也變慢, 因此 濃度保持約 0.15M 較佳。他除了可以調整酸鹼度也可作金屬螯合劑之用
f.由探討得知檸檬酸鈉濃度作通當調整可有效改變鍍層磷含量
H.一般還原劑大分為兩類:
次磷酸二氫鈉(NaH2PO2H2O, Sodium Hypophosphate)系列及硼氫化鈉(NaBH4,Sodium
Borohydride)系列,硼氫化鈉價貴因此市面上多以次磷酸二氫鈉為主 一般公認反應為:
[H2PO2]- + H2Oa H+ +[HPO3]2- + 2H(Cat) -----------(1) Ni2+ + 2H(Cat)a Ni + 2H+---------------------------(2) [H2PO2]- + H(Cat)a H2O + OH- + P------------------(3)
[H2PO2]- + H2Oa H+ + [HPO3]2- + H2-----------------(4)}
銅面多呈非活化性表面為使其產生負電性以達到"啟鍍"之目的銅面采先長無電鈀的方式 反 應中有磷共析故,4-12%含磷量為常見。故鎳量多時鍍層失去彈性磁性,脆性光澤增 加,有利防 銹不利打線及焊接
14.3.3 無電金
A.無電金分為"置換式鍍金"與"無電金"前者就是所謂的"浸鍍金"(lmmersion Gold plating) 鍍層 薄且底面鍍滿即停止。後者接受還原劑供應電子故可使鍍層繼續增厚無電鎳。
B.還原反應示性式為: 還原半反應: Au+ + e- + Au0 氧化半反應式: Reda Ox + e- 全反應式:
Au+ + Red aAu0 + Ox.
C.化學鍍金配方除提供黃金來源的錯合物及促成還原的還原劑,還必須並用螯合劑、安定劑、 緩衝劑及膨潤劑等才能發揮效用
D.化學金配方組成及功用:
E.部份研究報告顯示化學金效率及品質的改善,還原劑的選用是關鍵,早期的甲醛到近期的 硼 氫化合物,其中以硼氫化鉀最普遍效果也佳,若與他種還原劑並用效果更理想。代表反應式如後:
還原半反應: Au(CN)-2 + e-a Au0 + 2CN-:
氧化半反應式: BH4- + H2O a BH3OH- + H2
BH3OH- + 30H- a BO2- + 3/2H2 + 2H20 +3e-
全反應式: BH3OH"+3AU(CN)z"+30H` -, BOz 吐 + /2Hz+2H,0 +3Auo 6CN- F.鍍層之沉積速率隨氫氧化鉀及還原劑濃度和槽溫提高而提升,但隨氰化鉀濃度增加而降低 G.已商業化的制程操作溫度多為 9O℃左右,對材料安定性是一大考驗 H.細線路底材上若發生橫向成長可能產生短路的危險 I.薄金易有疏孔易形成 Galvanic Cell
Corrosion K.薄金層疏孔問題可經由含磷後處理鈍化方式解決
14.3.4 制程重點:
A.鹼性脫脂: 為防止鈀沉積時向橫向擴散,初期使用檸檬酸系清潔劑。後因綠漆有疏水性, 且鹼性清潔 劑效果又較佳,同時為防止酸性清潔劑可能造成的銅面鈍化,故采磷酸鹽系直煉非離 子性 清潔劑,以容易清洗為訴求。
B.微蝕: 其目的在去除氧化獲得新鮮銅面,同時達到絕對粗度約 0.5-1.0μm 之銅面,使得鍍鎳 金後 仍能獲得相當粗度,此結果有助打線時之拉力。配槽以 SPS 150g/l 加少量鹽酸,以保持氯 離 子約 2OOppm 為原則,以提高蝕刻效率。
C.銅面活化處理 鈀約 3ppm,操作約 40℃, 一分鐘,由於氯化鈀對銅面鈍化比硫化鈀為快,為 得較好的鎳結 合力自然是硫化鈀較適當。由於鈀作用同時會有少量 Cu+會產生,它可能還原成 Cu 也可能 氧化成 Cu++,若成為銅原子則沉積會影響鈀還原。為使鈀還原順利須有吹氣攪拌,風量 約 為 0./~O.15M3/M2*min 以上,促使亞銅離子氧化並釋出電子以還原鈀,完成無電鎳沉積的動作。
D.活化後水洗: 為防止鎳層擴散,清除線路間之殘鈀至為重要,除強烈水洗也有人用稀鹽酸浸漬 以轉化死角 的硫化鈀防止鎳擴散。為促進鎳還原,熱水預浸將有助於成長及均勻性,其想法在提 高活 性使大小面積及高低電壓差皆因提高活性而使差異變小以達到均一的目的。
E.無電鎳: 操作溫度 85±5℃ ,PH4.5~4.8,鎳濃度約為 4.9~5.1 g/l 間,槽中應保持鎳濃度低於
5.5 ,否則有氫氧化沉澱的可能,若低於 4.5g/l 則鍍速會減慢,正常析出應以 15μm/Hr,Bath loading 則應保持約 0.5~1.5)dM2/l,鍍液以 5 g/l 為標準鎳量經過 5 個 Turn 即必須更槽 否則析出鎳品質會 變差。鎳槽可以 316 不銹鋼製作,槽體事先以 50%硝酸鈍化,並以槽壁 外加電解陽極以防止鎳沉 積,陰極可接于攪拌葉通以 0.2~0.4 A/M2(0.018~0.037 ASF)低 電流,但須注意不能在槳葉區產生 氣泡否則代表電流太強或鎳鍍層太厚必須燒槽。建浴操 作應維持在 PH=5~4.7 間,可用 NaOH 或 H2S04 調整,PH 低於 4.8 會出現混濁,槽液老化 PH 操作範圍也會逐漸提高才能維持正常析出速 度。因線路底部為死角,易留置反應後所留的 殘堿 ,因此對綠漆可能產生不利影響, 必須以加 強攪拌及震動使殘堿及氣泡去除。
F.無電鎳磷含量: 一般無電鎳多以"次磷酸二氫鈉"為還原劑,故鍍層會含有一定量的磷約
4~6%,且部份呈結 晶狀。苦含量在 6~8% 中含量則多數呈非結晶狀,當高達 12%的以上則幾乎 全呈非結晶組織。 就打線而言,中磷含量及硬度在 500~600HV 最佳,焊錫性也以 9%最好。一般 在添加四回後 析出磷含量就會達到 10%應考慮換槽,打線用厚度應在 130μ 以上。
G.無電金:
以檸檬酸為錯合劑的化學金槽,含金 5g/l,槽體以 PP 為材質。PH=5.1~5.3 時可與銅作用, PH=4.5~4.8 時可與鎳作用實行鍍金,PH 可以檸檬酸調整之。一般操作溫度在 85℃,厚度幾乎會停 止在 2.5μ"左右,大約五分鐘就可達到此厚度,高的溫度固然可加快成長但因結晶粗反而防蝕能力 較差。由於大半采置換反應,因此會有不少的鎳溶入液中,良好的管理最好不要讓鎳濃度超過
2OOppm ,到 40Oppm 時金屬外觀及附著力都變差,藥水甚至變綠變黑,此時必須更槽。金槽對 銅離子極敏感,2Oppm 以上析出就會減緩,同時會導致應力增大。鍍鎳後也不宜久置,以免因鈍 化而無法析鍍,故鎳後水洗完應盡速進入金槽,有時為了特定狀況則作 10%檸檬酸浸泡再進入金 槽也能改善一些結合力。經鍍金後的鍍面仍難免有部份疏孔,此鍍件經水洗後仍應經一道封孔處 理,如此可使底層鎳經有機磷的處理增加其耐蝕性。
14.4 結語
A. OSP 制程成本最低,操作簡便,通常終檢電測完,包裝前作業之.但此制程因須裝配廠修改設備 及制程條件且重工性較差因此普及度仍不佳有待雙方努力.
B. 化鎳金制程則因成本極高,會鎖定某些領域的板子如 COB,IC Substrate 等,不會普及化.
C. 目前也有其他較低成本而仍有化鎳金功能之產品如 Pd/Ni,Sn, Organic Silver 等,以後陸續會 再做探討.
資料來源:參考網路 page 13

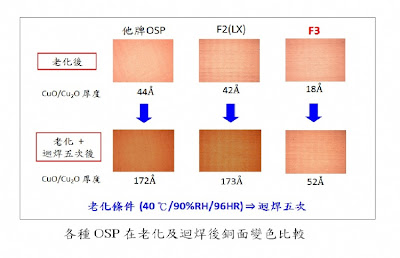
沒有留言:
張貼留言